- 技术文章
半导体常见气体的用途
2020-07-30 22:12:10 来源:浙江米勒洁净设备科技有限公司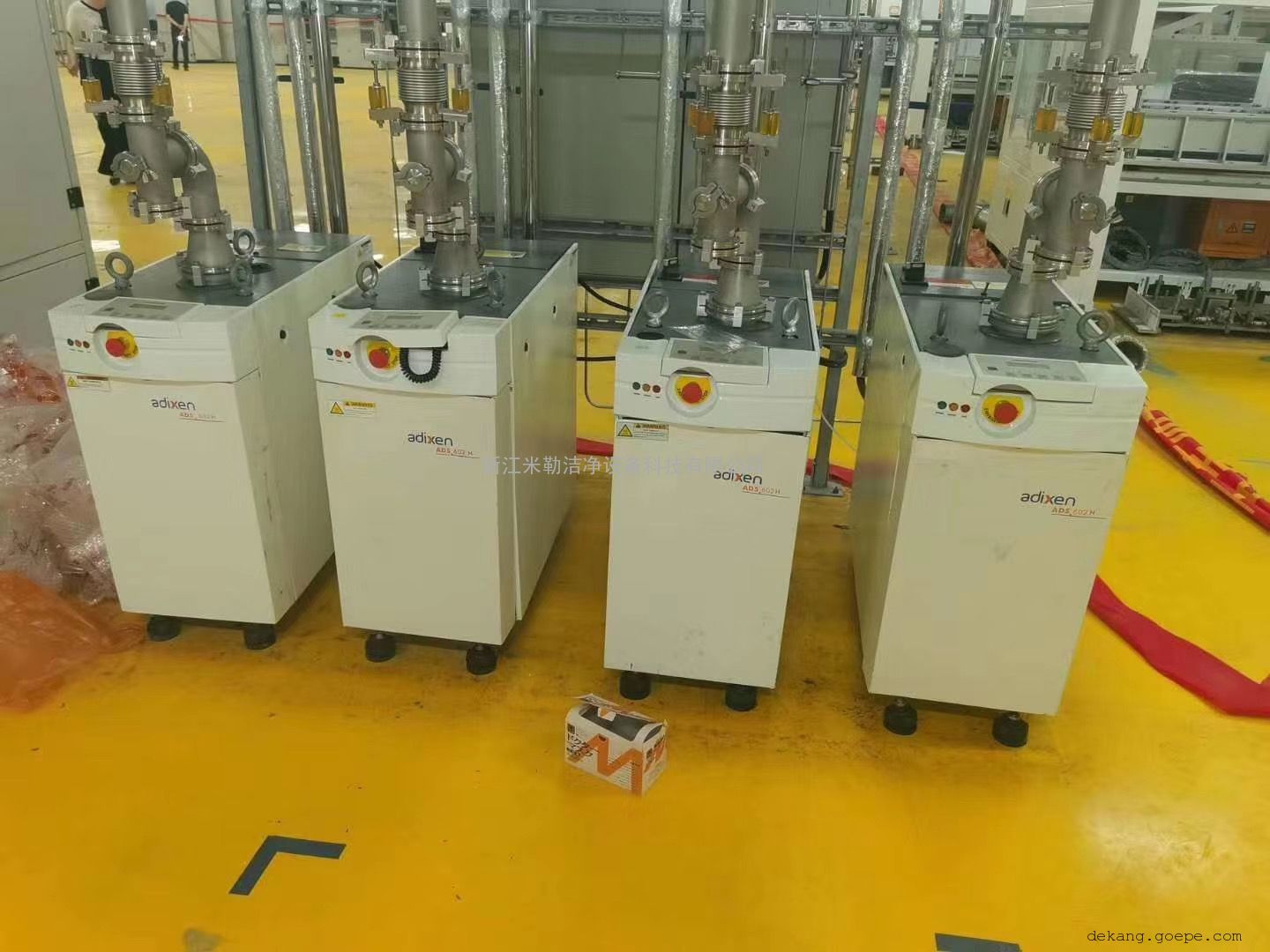 半导体常见气体的用途1、硅烷(SiH4):有毒。硅烷在半导体工业中主要用于制作高纯多晶硅、通过气相淀积制作二氧化硅薄膜、氮化硅薄膜、多晶硅隔离层、多晶硅欧姆接触层和异质或同质硅外延生长原料、以及离子注入源和激光介质等,还可用于制作太阳能电池、光导纤维和光电传感器等。,
半导体常见气体的用途1、硅烷(SiH4):有毒。硅烷在半导体工业中主要用于制作高纯多晶硅、通过气相淀积制作二氧化硅薄膜、氮化硅薄膜、多晶硅隔离层、多晶硅欧姆接触层和异质或同质硅外延生长原料、以及离子注入源和激光介质等,还可用于制作太阳能电池、光导纤维和光电传感器等。,
2、锗烷(GeH4):剧毒。金属锗是一种良好的半导体材料,锗烷在电子工业中主要用于化学气相淀积,形成各种不同的硅锗合金用于电子元器件的制造。$
3、磷烷(PH3):剧毒。主要用于硅烷外延的掺杂剂,磷扩散的杂质源。同时也用于多晶硅化学气相淀积、外延GaP材料、离子注入工艺、化合物半导体的MOCVD工艺、磷硅玻璃(PSG)钝化膜制备等工艺中。2 L/ F) Q%|) `1 o5 k
4、砷烷(AsH3):剧毒。主要用于外延和离子注入工艺中的n型掺杂剂。9 ?,
5、氢化锑(SbH3):剧毒。用作制造n型硅半导体时的气相掺杂剂。
6、乙硼烷(B2H6):窒息臭味的剧毒气体。硼烷是气态杂质源、离子注入和硼掺杂氧化扩散的掺杂剂,它也曾作为高能燃料用于火箭和导弹的燃料。
7、三氟化硼(BF3):有毒,极强刺激性。主要用作P型掺杂剂、离子注入源和等离子刻蚀气体。
8、三氟化氮(NF3):毒性较强。主要用于化学气相淀积(CVD)装置的清洗。三氟化氮可以单独或与其它气体组合,用作等离子体工艺的蚀刻气体,例如,NF3、NF3/Ar、NF3/He用于硅化合物MoSi2的蚀刻;NF3/CCl4、NF3/HCl既用于MoSi2的蚀刻,也用于NbSi2的蚀刻。
9、三氟化磷(PF3):毒性极强。作为气态磷离子注入源。3 `; |8 K, h* r:
10、四氟化硅(SiF4):遇水生成腐蚀性极强的氟硅酸。主要用于氮化硅(Si3N4)和硅化钽(TaSi2)的等离子蚀刻、发光二极管P型掺杂、离子注入工艺、外延沉积扩散的硅源和光导纤维用高纯石英玻璃的原料。
11、五氟化磷(PF5):在潮湿的空气中产生有毒的氟化氢烟雾。用作气态磷离子注入源。% D! Q. A$ P L$ V o
12、四氟化碳(CF4):作为等离子蚀刻工艺中常用的工作气体,是二氧化硅、氮化硅的等离子蚀刻剂。
13、六氟乙烷(C2H6):在等离子工艺中作为二氧化硅和磷硅玻璃的干蚀气体。
14、全氟丙烷(C3F8):在等离子蚀刻工艺中,作为二氧化硅膜、磷硅玻璃膜的蚀刻气体。
半导体工业常用的混合气体
1、外延(生长)混合气:在半导体工业中,在仔细选择的衬底上选用化学气相淀积的方法,生长一层或多层材料所用的气体叫作外延气体。常用的硅外延气体有二氯二氢硅()、四氯化硅()和硅烷等。主要用于外延硅淀积、氧化硅膜淀积、氮化硅膜淀积,太阳能电池和其它光感受器的非晶硅膜淀积等。外延是一种单晶材料淀积并生长在衬底表面上的过程。常用外延混合气组成如下表:序号 组份气体 稀释气体 1
2
3
4% D5硅烷(SiH4)
氯硅烷(SiCl4)
二氯二氢硅(SiH2Cl2)( b
乙硅烷(Si2H6)氦、氩、氢、氮
氦、氩、氢、氮5 X-
氦、氩、氢、氮 {( k
氦、氩、氢、氮
2、化学气相淀积(CVD)用混合气:CVD是利用挥发性化合物,通过气相化学反应淀积某种单质和化合物的一种方法,即应用气相化学反应的一种成膜方法。依据成膜种类,使用的化学气相淀积(CVD)气体也不同,以下表是几类化学气相淀积混合气的组成:;膜的种类 混合气组成8 T! r. M1 \! o! ]4 W! 生成方法3 W0 C! y2 半导体膜+
绝缘膜" C
导体膜2 w硅烷(SiH4)+氢/ s: v% u# d" f$ 二氯二氢硅(SiH2Cl2)+氢7 ]4 ?0
氯硅烷(SiCl4)+氢
硅烷(SiH4)+甲烷(CH4)
硅烷(SiH4)+氧" U6 H: b7 v. W)
硅烷(SiH4)+氧+磷烷(PH3)% ~.
硅烷(SiH4)+氧+乙硼烷(B2H6)
硅烷(SiH4)+氧化亚氮(N2O)+磷烷
六氟化钨(WF6)+氢1 Q0 Z7 ^. g1
六氯化钼(MoCl6)+氢CVD
CVD! d( s4 |: |] CVD
离子注入CVD
CVD
CVD' k9 I* m$ @, j CVD
离子注入CVD$ k2
CVD* D ~! }! z,
CVD" M; p7 \6 R/ u z
3、掺杂混合气:在半导体器件和集成电路制造中,将某些杂质掺入半导体材料内,使材料具有所需要的导电类型和一定的电阻率,以制造电阻、PN结、埋层等。掺杂工艺所用的气体称为掺杂气体。主要包括砷烷、磷烷、三氟化磷、五氟化磷、三氟化砷、五氟化砷、三氟化硼、乙硼烷等。通常将掺杂源与运载气体(如氩气和氮气)在源柜中混合,混合后气流连续注入扩散炉内并环绕晶片四周,在晶片表面沉积上掺杂剂,进而与硅反应生成掺杂金属而徙动进入硅。常用掺杂混合气:1
3 ?, a+ h+Q V; ?, `# l* C类型 组份气 稀释气7 备注 硼化合物
磷化合物
砷化合物乙硼烷(B2H6)、三氯化硼(BCl3)、溴化硼(BBr3)
磷烷(PH3)、氯化磷(PCl3)、溴化磷(PBr3)
砷烷(AsH3)、三氯化砷(AsCl3)氦、氩、氢
氦、氩、氢
氦、氩、氢3
4、蚀刻混合气:蚀刻就是将基片上无光刻胶掩蔽的加工表面(如金属膜、氧化硅膜等)蚀刻掉,而使有光刻胶掩蔽的区域保存下来,以便在基片表面上获得所需要的成像图形。蚀刻方法有湿法化学蚀刻和干法化学蚀刻。干法化学蚀刻所用气体称为蚀刻气体。蚀刻气体通常多为氟化物气体(卤化物类),例如四氟化碳、三氟化氮、三氟甲烷、六氟乙烷、全氟丙烷等。常用蚀刻气体如下表:
3 i$ O8 o$ I5 |# M材质 蚀刻气体5 U U x: M @6 b: m 铝(Al)
铬(Cr)
钼(Mo)
铂(Pt)8 聚硅
硅(Si)
钨(W) l$氯硅烷(SiCl4)+氩、四氯化碳(CCl4)+(氩、氦)
四氯化碳(CCl4)+氧、四氯化碳(CCl4)+空气
二氟二氯化碳(CCl2F2)+氧、四氟化碳(CF4)+氧% n4 @ 三氟三氯乙烷(C2Cl3F3)+氧、四氟化碳(CF4)+氧
四氟化碳(CF4)+氧、乙烷(C2H6)+氯"
四氟化碳(CF4)+氧8 f, G7 I/ G2 N9 q
四氟化碳(CF4)+氧
5、其它电子混合气:-63 w%序号( 组份气. [: \9 z! 稀释气' r$ q2 组份气含量范围0 Z( U; 1
25 3
48
5$
67
77
8
92
10氯化氢(HCl)
硒化氢(H2Se)
锗烷(GeH4)
磷烷(PH3)
砷烷(As2H3)0 Q; }乙硼烷(B2H6)) F
硅烷(SiH4)# s3
二乙基碲(C2H5)2Te
氯(Cl2)
一氧化碳(CO)
氧、氮!o
氩、氦、氢、氮6
氩、氦、氢、氮6氩、氦、氢、氮
氩、氦、氢、氮
氩、氦、氢、氮
氩、氦、氢、氮+氩、氦、氢、氮#
氮
六氟化硫( t: J3 f! u5 F* y1―10%
5―5000×10-6
1―5%
5―5000×10-6、0.5―15%
5―5000×10-6、0.5―15%
5―5000×10-6、0.5―15%
5―150×10-67
28%
22%
-
产品搜索
-
产品分类
-
不锈钢人孔,卫生级人孔
-
食品.制药 机械配件系列
-
搅拌罐,移动搅拌罐
-
不锈钢卡箍 管夹系列
-
不锈钢弯头,卫生级弯头
-
乳品设备
-
过滤器系列
-
卫生级不锈钢液位计阀
-
石油,化工机械配件系列
-
不锈钢丝扣阀门系列
-
不锈钢离心泵,卫生自吸泵
-
罐用组件,罐配件系列
-
食品,制药,乳品,机械
-
【生化专用截止阀】
-
不锈钢蒸汽疏水阀
-
不锈钢镜面管 食品级钢管
-
不锈钢输酒软管
-
不锈钢封头
-
卡箍式法兰蒸汽电磁阀
-
洁净穿墙套管
-
双管板c
-
无负压供水设备
-
压力.液位变送器
-
超洁净不锈钢管阀
-
乳化机#分散机#浆式搅拌机
-
大口径不锈钢管
-
06cr19ni10无菌不锈钢法兰
-
卫生洁净地漏系列
-
罐车人孔
-
油罐车人孔,
-
不锈钢水帽 树脂捕捉器
-
环保设备类
-
米勒板
-
进口防腐软管
-
酒精塔填料
-
不锈钢阀门
-
真空元件
-
卫生级钢管
-
压力容器视镜 条形视镜
-
不锈钢法兰
-
不锈钢活接头
-
不锈钢接头
-
医用真空负压除菌过滤器
-
-
公司相册
-
我的相册
2218张图片
-
 扫一扫,手机浏览
扫一扫,手机浏览